�S��оƬ�����ߴ�ij��m�s���O�����̑{�聆20 nmֱ�ӳ����������ѳɞ�7 nm���������M�Ƴ̵����a���ķ�������ƥ����H�����cϵ�y·���DҪ���_�l���8-16 nm�ֱ��ʡ�60 mJ/cm2�����`���Ⱥ�10%���¾�߅���ֲڶȵĸ����ܹ���z����ü�ޡ��M�ܘO�����̮�ǰռ��������λ���������������̑{����o�������Ƶľ��ȃ��ݺͶ��^�����ع����������@���������aЧ�ʣ�ʹ�����������̳ɞ���һ����̼��g�����������ߡ��ڴ˱����£��_�l��ͬ���m��O�������c�������̵����`��������z��֬�����H�܉���ݬF���O��������ˇ��߀�ɞ�δ�����g���M�ṩ�`���Q������������Ҫ�Įa�I���rֵ��
�䱶����������z�Ƿֱ�������������������z֮һ������չ�F���@���ĘO���⑪�Ý�������߂䁆10 nm�ֱ��ʺ̓��������g���ܣ������^С�ķ��ӳ߶ȿ����ƈD���ֲڶ��S�s������Ć��}��Ȼ�����䱶���������е����`���ȣ��ع℩��>360 mJ/cm2�����^��ĭh�������������z���r�g<54h�������Ƽs�����ژO�������еđ��Ý��������ڴˣ�ͨ�^���Ӹ����ڱ����䱶����������z�����ֱ��ʃ��ݵ�ͬ�r�������`�����c���淀���ԣ�����չ�����O�����̑����I��Ŀ���;����
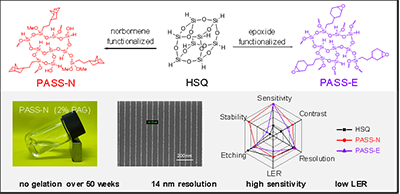
�D1�����ܽ���Ƭϩ��/�h�����Ե�������������z�����Բ��ԡ����W�Y�����������ܺ������
��2021�����㽭��W��V����ڈF��c���ݎ�����W������ڈF��_չ��Ⱥ�����ͨ�^ϵ�y�Y�x52�N�ЙC���Ա��������Y������ʾ���ЙC���Ԍ������������ܵ�Ӱ�Ҏ�ɡ��о��l�F���������������������z�����wϵ�Ɍ��F23 nm���߷ֱ��ʣ��䷀�����^���y�䱶����������������6�����Fꠄ������������Ч���cλ��Ч�����ÙC����������ܱ�����������z�OӋ�ṩ����Փ����(ACS Appl. Mater. Interfaces 2024, 16, 51554?51564)��
���ڣ��p���о��F��ٶȔy�ֺ������������z-���z���������ӳɷ������ɹ��Ƃ��˽���Ƭϩ���Եı�������飨PASS-N���c�h�����Եı�������飨PASS-E�����������c���®a�ᄩ��Y�ϣ��аl��һ�N������z�wϵ��ԓ�wϵ�ڷֱ��ʡ��`���ȼ����淀���Է�����F��Խ���ܡ��о���ʾ��ԓ����z���ܵ��@�������w�����ЙC�����c���®a�ᄩ�ąfͬЧ�����ЙC���Fͨ�^����Si-H�I�������������淀���ԣ�����ͻ��F�c�h�����F�t�����˹����ԣ����®a�ᄩ�tͨ�^���M�����齻����������`���ȣ���ͨ�^���ƹ����ĵ��H�˹�������ƹ���z�ă��淀���ԡ�ͨ�^ϵ�y����ȡ�����F����������z�䷽����̹�ˇ�ȅ�����ԓ����z���`�����_��4.3 mC/cm2�����ȶȞ�5.1���ֱ��ʞ�14 nm����߅���ֲڶȞ�1.3 nm���M���ˇ��H�����cϵ�y·���D����7nm���c�����Ҫ���⣬ԓ����z�����z�r�g�L�_360�죬���^���̘I��ʹ�õ��䱶������飬�䃦�淀���������160��֮����

�D2 ���`���߷�����PASS����z���OӋ����
��������ͨ�^���z-���z�������ӳɷ����քe�Ƃ���PASS-N��PASS-E�ɷN�ЙC���Ա�������顣����Ҫ�OӋ������D2��ʾ��1���Ȳ���Si-O-Si�o�C�Ǽ��x�����z�����Ŀ����g���ܣ�2�����ֱ�����Si-H�I�ھS�ֻ���𤸽�Ե�ͬ�r���������ЙC���F���댧�µĿ����g���@���½���3��Si-OH���Fͨ�^�װl����Óˮ�s�Ϸ����ṩ�~������ԣ�4�������֬�h���F����C=C�p�I�ͭh�����F�ȹ����Y�����ɴ����������z���`���ȡ��@�N����܈F�fͬ�OӋ���F�˿����g�ԡ�𤸽�Ժ����Ե�ƽ�⃞����

�D3 PASS����z�ķ����Ա���
ᘌ��䱶����������z�ĺ��ķ����Ԇ��}�������Ժ�10%����Ƭϩ���F��PASS-N10%���о�����ϵ�y�����˹��®a�ᄩ�ķ��������á��о��@ʾ������2 wt%���®a�ᄩ������������������f�}����PASS-N10%���F�������ă��淀���ԣ��ڭh���l������360��δ�l�����z�����D3a�����@�N����Ч��Դ���ڵ��f�}��x�Ӿ����H��ԣ��܉���Ч���ƭh���A���ڹ�ԭ�ӵ��H���M���^�̣��Ķ����ˮ�T���ı���������ѽ����@�DZ���������wϵ���P�I����;��������C���®a�ᄩ�ı��oЧ�������ߌ��Ȝyԇ��δ���ӹ��®a�ᄩ��PASS-N10%���Y���@ʾ������Ʒ����ͬ�l����48С�r�ȼ��l���������z�����D3a�����@һ�F���C���˹��®a�ᄩ�����Ϸ����Ե��P�I���á��Mһ���Ĺ�������u����������2 wt%���®a�ᄩ��PASS-N10%�ڃ���14������`���ȡ����ȶȺͷֱ��ʵ��P�I���������ַ������D3b-e�����@�������®a�ᄩ�ē����@�����L��PASS����z��ʹ�É�����������������P�I�ߴ���ơ��@һ�M����Ч�ؽ�Q�˂��y�䱶����������z�ķ�����ȱ�ݣ���ˇ����<54 h�����Ķ���Q�˱�����������z���I���õ��ϵK��

�D4 PASS-N����z��������������
�ڽ�Q��PASS����z�ă��淀���Ԇ��}������ϵ�y�Ե��о���PASS-N����z�������������ܡ�ͨ�^����ȡ�����F�������®a�ᄩ�������_�������z�䷽�飺ʹ�ú�50%����Ƭϩ���F��PASS-N50%�������Ĥ��֬������5 wt%���®a�ᄩ������10 wt%�ļ��������@ˮ��Һ�����@ӰҺ�r��PASS-N50%���W�Ŵ����z���F���˃����Ĺ�����ܣ��`����4.3 mC/cm2�����ȶ�5.1��������0.16 nC/cm�ij����ع℩�����F14 nm�������l�Y���Լ�����s�D�����Ƃ䣨�D4����ֵ��ע����ǣ��о��l�FPAG�����벻�H�@�������˹���z���`���ȣ�ͬ�r�����ˌ��ȶȣ�ͻ���˂��y����z���`�����c���ȶȵę���Pϵ���@һ�l�F�ɚw���ڹ��®a�ᄩ�Ķ������ÙC�ƣ�1������������˱���������g�Ľ�������2�����®a�ᄩ���ع�ǰ���ܽ�ȵ��@��׃������Ч�������ع�^�cδ�ع�^���ܽ⌦�ȶȣ�3������������������f�}����ɹ�ֽ���H��ԇ���������������x���ܸ�Ч���δ�ع�^����x�ӻ��ԷN��

�D5 PASS-N��PASS-E���W�Ŵ����z�c�̘I���䱶����������܌���
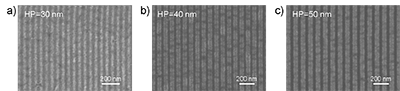
�D6 PASS-E���W�Ŵ����z�ĘO�����̽Y��
��ϵ�y�u��PASS���W�Ŵ����z�����܃��ݣ����ߌ����c���Ú䱶����������z�M����ȫ�挦�ȷ���������������PASS����z���P�I����ָ���ό��F���@��ͻ�ƣ�1) �`���������_37����4.3 mC/cm2 vs 160 mC/cm2����2) ���淀�������L�_160����360�� vs 54С�r����3) ���ȶ��c�ֱ���ͬ����ߣ�ͬ�r�������ஔ�ľ�߅���ֲڶ�ˮƽ���M�ܿ����g���ܴ���22%�Ľ��ͣ�����C������ָ����չ�F��ͻ���ļ{�����쑪�Ãrֵ���D5����ͬ�r��PASS-E���W�Ŵ����z�ژO�����̜yԇ�гɹ��Ƃ�30 nm�ܼ���ňD�����D6�����@һ�Y��ֱ����C��PASS���W�Ŵ����z����һ����̼��g�еČ��H���Ý�����

�D7 PASS���W�Ŵ����z���ع�C��
��Y��ģ�ͻ������Լ��@���������Y������������˹��®a�ᄩ�c��Ĥ��֮֬�g�ąfͬ���ÙC�����D7������Ҫ���������Ă����棺1�����淀���ԣ����®a�ᄩ�ڃ����^�������ƹ����ĵ��H���M�����Ķ���߹���z�ķ����ԣ�2���p���C�ƣ�������ع��T��֬�h���F�cSi-OH�ij��������S���ں���A��ͨ�^������F�μ������@�������`���ȣ�3���ܽ����ƙC�������®a�ᄩ���ع�ǰ���ܽ�ȵ��@����������ع�^�cδ�ع�^���ܽ⌦�ȶȣ�4���H��⧜�C��������������������f�}����ɹ�ֽ���H��ԇ���������������x���ܸ�Ч���δ�ع�^����x�ӻ��ԷN���@�Mһ������˹���z�Č��ȶȡ��@�N�fͬ�C��ʹPASS���g���܉�ͬ�r���F�������ķ����ԡ��`���ȣ�ͨ�^������ͷֱ������ܣ�ͨ�^PASS�^С�ķ��ӳߴ硢�ܽ����ƙC�ƺ��H�˴��C������
ԓ�����OӋ�ϳ���һ��и��`���Ⱥ߷����ԵĽ���Ƭϩ��/�h����ȡ��������������z��̽����ԓ�wϵ�Ĺ�̙C�������F�˃����Ĺ�����ܣ����_�l�����ܘO�������z�ṩ��һ�N��˼·����������Փ������һ��������������������c���@һ�о��������㽭��W��V�����ںͺ��ݎ�����W����������Փ�ĵ���ͬͨӍ���ߡ������e���x�㽭��W��늌WԺ����ڡ����_��W�_����ڡ��Ї��Ƽ���W��˼������������͘O�����̵ȷ��������֧�֡�ԓ�о��õ���������Ȼ����ƌW�������������c�аlӋ�����㽭ʡ�ܳ�����ƌW���𡢺��ݎ�����W�Ƿ幤���_�Ż������Y����
ԭ��朽ӣ�Norbornene and Epoxide-Substituted Silsesquioxane Photoresists with High-Sensitivity and Stability, ACS Nano, 2025.
https://doi.org/10.1021/acsnano.5c06472
- ���ϴ�W���i/�ӱ�����������/���ϴ�W�R��/ɽ����� AFM������ˮ���OӋ�ĸ߷����ԑ������{��܂������z�w�S 2026-02-22
- �A�ώ��������ߴ�ҫ�� IJBM�����и߷������c������ܵĽ��S�ؾ������������ί��~���c���ϵđ��� 2025-08-07
- ���ϴ�W���i/�������ϴ��۵� AFM�����и�푑��ٶ��c�߷����Ե����ԜضȂ����� 2025-07-15
- ���ϴ�W��ͬ�A/���ӹ���������ش�� AM�������߂䳬���`���Ⱥ͌������z�y�������p��늌��x����Ӊ��������������F�ض�/�����pģ�B��֪�c�o���Z���R�e 2025-07-24
- ���ڼ��g��Wʷ���|�� Carbon������ʯīϩ-�{���w�S�؏ͺϱ�Ĥ�����ޏ͑�׃/����pģ���������OӋ���ڿɴ��������O�y�đ��� 2025-05-28
- �������̴�W���������ڈF� AFMs���߂���`���ȵķ�DNA�p�����ް������w�S���W�������������w�\�ӱO�y 2025-05-19
- ���A��W�S�Aƽ���� Sci. Adv.���������� - һ�N����ĘO���⣨EUV������z 2025-07-21
